Minimal Multi-Target Sputtering (1)

Minimal Multi-Target Sputtering - Высокоскоростная система распыления под низким давлением с использованием геликон-волновой плазмы. Возможно использование 3 мишени (Al, Cu, Ti).
Minimal Multi-Target Sputtering состоит из геликонового источника плазмы с ступенчатым диаметром, дающим высокую плотность плазмы ниже по потоку от источника, отрицательно смещенной вращающимися мишенями и столиком подложки, включающей магнитный фильтр.

Компактный геликонный плазменный источник с перестройкой частоты прикреплен на боковой стенке компактной вакуумной камеры, а плазма притягивается вдоль изогнутых линий магнитного поля к поверхности мишени, которая установлена на вращающемся держателе мишени и отрицательно смещённый источник питания постоянного тока. Материал мишени распыляется ионами, ускоренными падением потенциала оболочки, и осаждается на подложку, которая обращена к этой мишени. Материал мишени можно изменить, повернув держатель таким образом, что позволяет формировать многослойную металлическую пленку в одной камере. Нагревание подложки, вызванное вторичными электронами, испускаемыми с поверхности мишени и ускоренными оболочкой, успешно подавляется магнитным фильтром, который расположен рядом с подложкой.
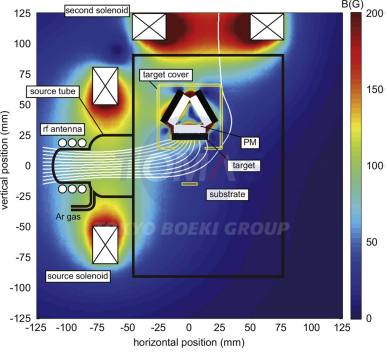
Рис. 1. Принципиальная схема экспериментальной установки вместе с рассчитанными линиями магнитного поля (сплошные линии) и напряженностью (цвет контура) для тока источника соленоида и тока второго соленоида.
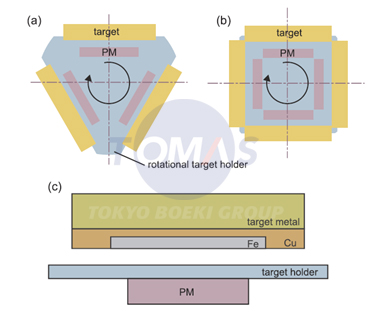
Рис. 2. Принципиальная схема держателей мишеней, имеющих (а) тройные и (б) четверные мишени. (В) Вид в поперечном сечении мишени, включая ферромагнитную пластину, которая может быть прикреплена к держателю мишени с помощью магнитной силы.
На рисунке ниже показан профиль глубины многослойной металлической пленки Ti, Cu и Al, нанесенной на кремниевую подложку, полученный методом GD-MS. Расстояние мишень-подложка (T-S) выбрано равным 30 мм. Скорость осаждения около 200 нм / мин для Cu, около 140 нм / мин для Al и Fe и около 80 нм / мин для Ti успешно получены для расстояния TS 30 мм. Показано, что присутствие магнитного фильтра может препятствовать нагреву подложки, вызванному вторичными электронами высокой энергии, испускаемыми из мишени. При установке расстояния TS на 35 мм можно получить профиль толщины пленки в пределах ± 5%, где скорость осаждения составляет около 100 нм / мин.
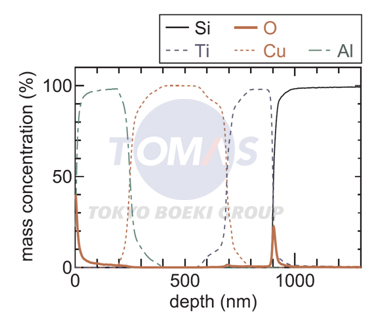
Рис. 3. Профиль глубины многослойной металлической пленки Ti, Cu и Al.
Спецификация
| Размеры и вес оборудования | |
|---|---|
| Размеры | Ш х В х Г:294х1440х450 мм |
| Вес | 100 кг |
| Подключение | |
| Питание | 1 фаза, ~100В, 10А, 50/60 Гц |
| Газ | Сжатый воздух 0.4 МПа, N2 |
| Баллон аргона | Встроенный в корпус (Также аргон может быть подведен из внешнего цилиндра) |
| Вакуумная система | |
| Система загрузки подложки | Vac PLAD |
| Вакуумная откачка | турбомолекулярный насос + сухой насос |
| Предельный уровень вакуума | 10-5 Па (возможен отжиг) |
| Контроль давления | контроль APC |
| Конфигурация устройства напыления | |
| Источник распыления | 1-дюймовыйисточник магнетронного распыления |
| Размер мишени | Ø32мм х 1мм толщина |
| Расход технологического газа (Ar) | до 20 см3. Реактивное распыление: может быть добавлен согласно запросу клиента |
| Подложка | 12.5 мм |
| Источник питания | |
| Источник постоянного тока (DC) | Максимальное напряжение: 1000 В, максимальный ток: 250 мА |
| HIPIMS | Ширина импульса: 3 ~200 мкс,частота: 5000 Гц |
| Высокочастотный источник (RF) | Частота: 13,56 Гц, мощность : 50 Вт / 200 Вт |
Литература:
1. Kazunori Takahashi, Taisei Motomura, Akira Ando, Yuji Kasashima, Kazuya Kikunaga, Fumihiko Uesugi, Shiro Hara3. Transport of a helicon plasma by a convergent magnetic field for high speed and compact plasma etching. Journal of Physics D: Applied Physics 47 (2014) 425201 (6pp).
2. Kazunori Takahashi, Taichi Saito, Hiroyuki Kawasaki, Hayato Chiba, Naoyo Yamamoto, Hisashi Mizuguchi, Michihiro Inoue, Shiro Hara. Development of a Minimal multi-target helicon sputtering tool, 2018 International Symposium on Semiconductor Manufacturing (ISSM), PE-O-11.
3. Kazunori Takahashi. Helicon?type radiofrequency plasma thrusters and magnetic plasma nozzles. Reviews of Modern Plasma Physics (2019) 3:3.
4. Taichi Saitoa, Kazunori Takahashia, Akira Andoa, Shiro Hara. Enhancement of downstream plasma density by a stepped-diameter radiofrequency plasma source under a static magnetic field for a compact sputtering reactor. Vacuum 163 (2019) 269–274.
5. Kazunori Takahashi, Taichi Saito, Akira Ando, Yuki Yabuta, Hisashi Mizuguchi, Naoko Yamamoto, Ryuichiro Kamei, Shiro Hara. Minimal multi-target plasma sputtering tool. Vacuum 171 (2020) 109000.

