Minimal SiN Mirror PE-CVD

Minimal SiN Mirror PE-CVD - Установка химического парофазного осаждения с усиленной плазмой для осаждения пленки SiN с низкой степенью дефектности.
Компактный источник ЭЦР ( электронно-циклотронный резонанс)-плазмы с ограниченным магнитным зеркалом был разработан для обработки плазмы с низким уровнем повреждений, особенно с целью реализации формирования высококачественной пленки нитрида кремния для процессов субмикронных устройств КМОП в при использовании производственной системе Minimal Fab.
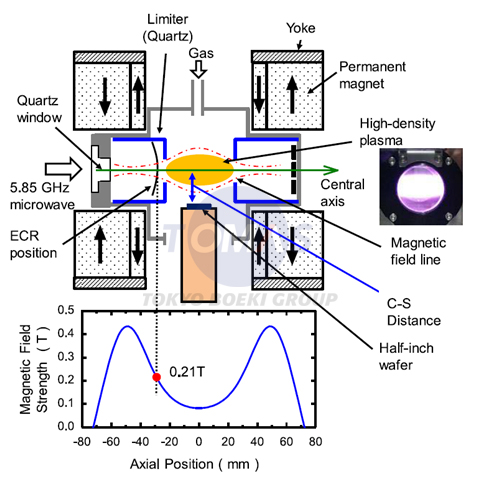
Рис. 1: Схематический вид нового источника плазмы, осевое распределение напряженности магнитного поля и фотография типичной плазмы Ar.
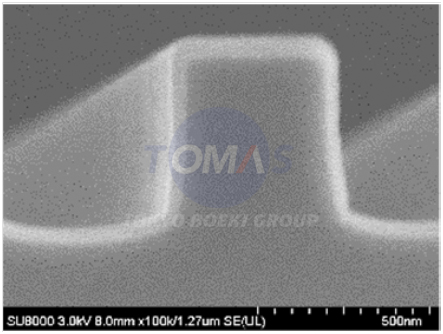
Рис 2. Пример пленки Si3N4: SiH4/N2=0.3/9sccm, 25Pa 350° 25W.
Пленка нитрида кремния, имеющая такое же отношение N/Si, что и у Si3N4, была получена при осаждении при комнатной температуре путем регулирования расхода SiH4 на уровне 25 Па. Было также обнаружено, что концентрация примесного кислорода в пленке может быть уменьшена менее чем на 1%, что было даже меньше, чем в контролируемой пленке, осажденной из газовой фазы при низком давлении при 750°C традиционным LPCVD.
Литература:
1. Tetsuya Goto, Kei-ichiro Sato, Yuki Yabuta, Shigetoshi Sugawa, Shiro Hara. New Compact ECR Plasma Source for Silicon Nitride Film Formation in Minimal Fab System. IEEE Electron Devices Technology and Manufacturing Conference Proceedings 2017, 5M-4, p.84.
2. Tetsuya Goto, Kei Ichiro Sato, Yuki Yabuta, Shigetoshi Sugawa, Shiro Hara. New Compact Electron Cyclotron Resonance Plasma Source for Silicon Nitride Film Formation in Minimal Fab System. IEEE Journal of the Electron Devices Society 2018, Volume 6, Page: 512 - 517.

