Minimal Mask Aligner
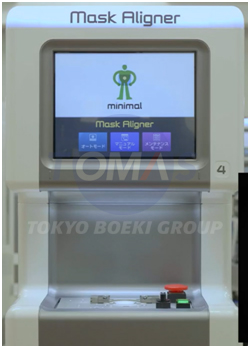
Minimal Mask Aligner - Установка выравниватель масок c функцией двустороннего выравнивания/совмещения. Ширина линии 1 мкм.
Описание:
Двухстороннее выравнивание возможно благодаря изображениям с передней и задней сторон пластины. Мощный светодиодный источник света может использоваться для экспонирования толстых пленок, что делает его идеальным для MEMS.

Шаблон 0.7 мкм

Экспонированный и проявленный шаблон

Изображение первого экспонирования

Совмещенное изображение размером 100 мкм

РЭМ изображение нанесенного резиста толщиной 1 мкм
Пример производства маски для Minimal Mask Aligner:
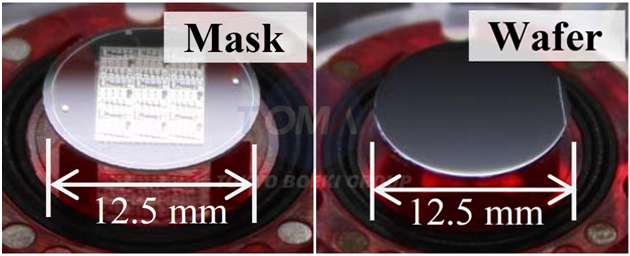
Маска и подложка для Minimal Fab
Таблица
| Маска | Подложка | |
|---|---|---|
| Толщина, мм | 0.25 | 0.25 |
| Диаметр, мм | 12.5 | 12.5 |
| Защитная пленка | Пленка Al | - |
| Подложка | стекло | Si |
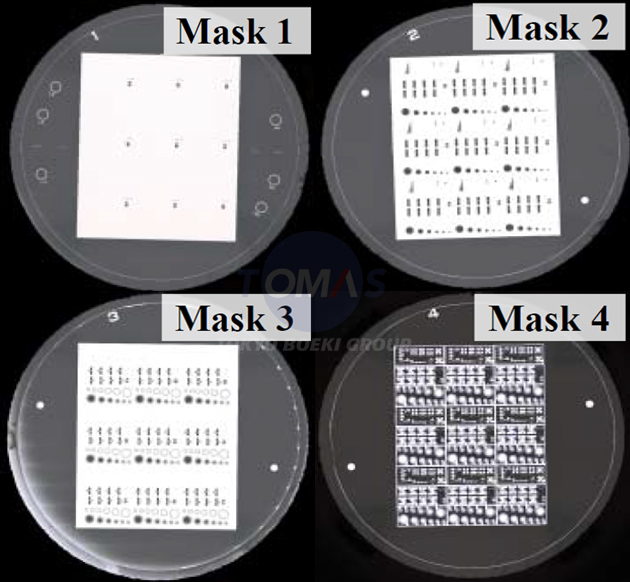
Оптическая микрофотография полученной маски pMOSFET (маски с 1 по 4)
Спецификация
| Оптическая система выравнивания | |
|---|---|
| Оптическая система маркировки | 2560 x1920, 4 –х пиксельная камера |
| Увеличение объектива | 4X |
| Освещение | Эпископическое, коаксиальное |
| Оптическая система ориентирования плоскости | 2560 x 1920, 2 –х пиксельная камера |
| Увеличение объектива | 0.8 крат |
| Выравнивание | Обработка изображений визуального, автоматического выравнивания и наблюдения на мониторе |
| Столик выравнивания | |
| Ход выравнивания XY | 8 мм |
| Источник перемещения | Импульсный мотор |
| Разрешение | 0.1мкм |
| Ход по оси Θ | ±3° |
| Разрешение | 0.00225° |
| Ход выравнивания Z | 30 мм |
| Источник перемещения | Импульсный мотор |
| Разрешение | 1мкм |
| Метод контроля | Контроль давления с помощью тензодатчика |
| Уровень оси | Автоматическая регулировка баланса с помощью контакта пластины и маски |
| Маска | |
| Размер маски | φ0.5дюйма, t = 0.8мм |
| Система экспонирования | |
| Источник экспонирования | LED365±5нм. |
| Интенсивность | 45 мВт/см2 (при расстоянии 50 мм) |
| Область облучения | 10 x 10 ммв пределах 3.6% |
| Интегратор объектива | 3 мм квадрат |
| Режим экспонирования | бесконтактный, установленный в зазоре с разрешением 0,1 мкм. Мягкий контакт Жесткий контакт |
Литература:
1. Norio Umeyama, Yuji Kitayama, Haruki Toonoe, Junko Kazusa, Sommawan Khumpuang, Shiro Hara, An in-line MINIMAL FAB process from producing photomasks to transistor fabrication. Proceedings of the 76th JSAP Autumn Meeting, 2015,13p-1C-1.
2. N. Umeyama, S. Khumpuang, S. Hara, An In-Line MOSFET Process With Photomask Fabrication Process In A Minimal Fab, IEEE Electron Devices Technology and Manufacturing Conference (EDTM) 2017, p.226

