Minimal TiN PVD

Minimal TiN PVD - Установка физического вакуумного осаждения TiN методом магнетронного распыления (HIPIMS - High Power Impulsed Magnetron Sputtering). Источник распыления: 1-дюймовый магнетронный источник распыления. Источник питания: DC, DC импульсный, доступный источник питания RF.
Особенности:
- Сверхкомпактный источник магнетронного распыления для равномерного осаждения.
- Простая замена мишени и обслуживание.
- Проверенные результаты для различных типов распыления, включая реактивное распыления (опция).
- Сверхмалый дуговой разряд позволяет осаждать плотную пленки.
Оснащен методом импульсной плазмы (HIPIMS).

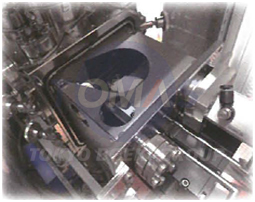

Осажденная пленка TiN
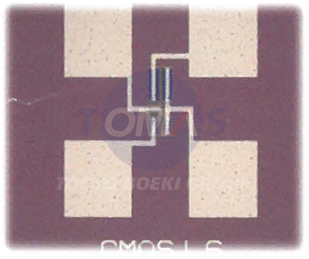
TiN затвор в SOICMOS
Пленка TiN, сформированная методом реактивного распыления, в котором титан используется в качестве материала мишени, а атомы азота разделяются плазмой. Важно, чтобы степень вакуума оборудования была хороша для реактивного осаждения. Устройство достигает пикового давления около 10-5 Па и реализует высококачественный слой TiN, который можно использовать в качестве затвора транзистора.
| Размеры и вес оборудования | |
|---|---|
| Размеры | Ш х В х Г:294х1440х450 мм |
| Вес | 100 кг |
| Подключение | |
| Питание | 1 фаза, ~100В, 10А, 50/60 Гц |
| Газ | Сжатый воздух 0.4 МПа, N2 |
| Баллон аргона | Встроенный в корпус (Также аргон может быть подведен из внешнего цилиндра) |
| Вакуумная система | |
| Система загрузки подложки | Vac PLAD |
| Вакуумная откачка | турбомолекулярный насос + сухой насос |
| Предельный уровень вакуума | 10-5 Па (возможен отжиг) |
| Контроль давления | контроль APC |
| Конфигурация устройства напыления | |
| Источник распыления | 1-дюймовыйисточник магнетронного распыления |
| Размер мишени | Ø32мм х 1мм толщина |
| Расход технологического газа (Ar) | до 20 см3. Реактивное распыление: может быть добавлен согласно запросу клиента |
| Подложка | 12.5 мм |
| Источник питания | |
| Источник постоянного тока (DC) | Максимальное напряжение: 1000 В, максимальный ток: 250 мА |
| HIPIMS | Ширина импульса: 3 ~200 мкс, частота: 5000 Гц |
| Высокочастотный источник (RF) | Частота: 13,56 Гц, мощность : 50 Вт / 200 Вт |
Литература:
1. Hisato Ogiso, Shizuka Nakano, Ken Yukimura, Akihiko Kato, Yuki Yabuta, Sommawan Khumpuang, Shiro Hara. The Small HIPIMS Plasma Source and the Application for Minimal Fab. 2013 Proceedings of the 74th JSAP Autumn Meeting, 2013, 18p-C5-7.
2. Hisato OGISO, Ken YUKIMURA, Shizuka NAKANO, Hiroyuki TANAKA, Sommawan KHUMPUANG, Yuuki YABUTA, Ryuichiro KAMEI, Shiro HARA. Development of Miniature Sputtering Deposition Equipment for Minimal Fab with HiPIMS Operations. Journal of the Vacuum Society of Japan 60(9):365-371 (2017).
3. Yongxun Liu, Hiroyuki Tanaka, Norio Umeyama, Kazuhiro Koga, Sommawan Khumpuang, Masayoshi Nagao, Takashi Matsukawa1, Shiro Hara. Investigation of piezoresistive effect in p-channel metal–oxide–semiconductor field-effect transistors fabricated on circular silicon-on-insulator diaphragms using cost-effective minimal-fab process. Japanese Journal of Applied Physics 57, 06HD03 (2018).
4. Yongxun Liu, Kazushige Sato, Hiroyuki Tanaka, Kazuhiro Koga, Sommawan Khumpuang, Masayoshi Nagao, Takashi Matsukawa, and Shiro Hara, "RTA-Temperature Dependence of Electrical Characteristics of PVD-TiN Metal Gate SOI-MOSFETs Fabricated on Half-Inch Minimal Wafers", International Conference on Solid State Devices and Materials (SSDM), Tokyo, 2018/9.
5. S. Noda, H. Tanaka, K. Nemoto, K. Koga, Y. Yabuta, N. Yamamoto, R. Kamei, S. Khumpwang, S. Hara. Formation of TiN Films Using Minimal Sputtering Tool. Proceedings of the 65 JSAP Spring Meeting, 2018б 20p-C101-4.
6. S. Noda, K. Koga, K. Nemoto, Y. Yabuta, N. Yamamoto, R. Kamei, S. Khumpuang, S. Hara. Film Characteristics deposited by Minimal Fab TiN Reactive Sputtering Tool. Proceedings of the 80th JSAP Autumn Meeting, 2019.

